www.industria-online.com
01
'26
Written on Modified on
ZEISS migliora la precisione FIB-SEM con Crossbeam 750
Il nuovo sistema combina imaging SEM in tempo reale e fresatura FIB con ottica Gemini 4 per migliorare la precisione dell’endpoint e i flussi di lavoro di analisi 3D.
www.zeiss.com
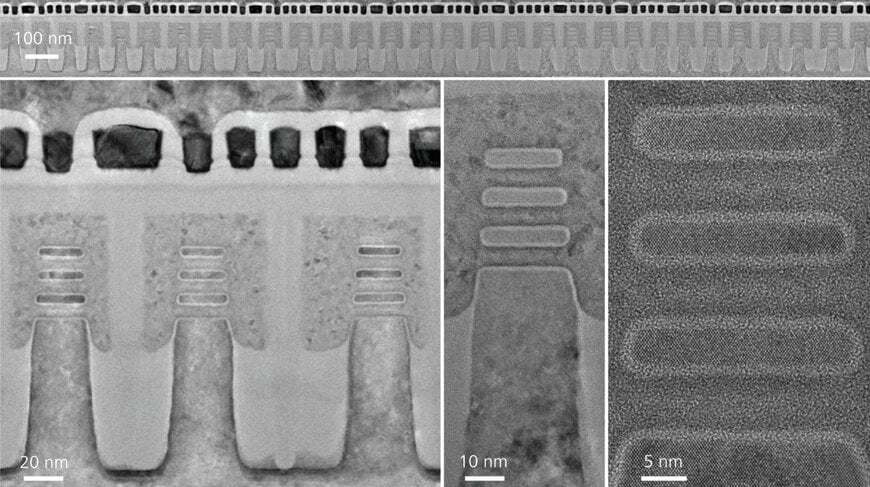
Le analisi nei semiconduttori, nelle scienze dei materiali e nei processi di nanofabbricazione richiedono una preparazione dei campioni precisa, imaging ad alta risoluzione e rilevamento accurato dell’endpoint su scala nanometrica. In questo contesto, ZEISS ha introdotto il Crossbeam 750 FIB-SEM, progettato per consentire la fresatura simultanea con fascio ionico focalizzato (FIB) e l’imaging mediante microscopia elettronica a scansione (SEM), garantendo un controllo continuo del processo durante la preparazione dei campioni.
Il sistema integra l’imaging in tempo reale con le operazioni di fresatura, permettendo agli utenti di monitorare la rimozione del materiale e l’evoluzione strutturale senza interrompere il processo. Questo approccio affronta un limite chiave dei flussi di lavoro FIB-SEM convenzionali, in cui l’imaging intermittente può portare a imprecisioni nel rilevamento dell’endpoint e a un aumento delle rilavorazioni.
Controllo di processo in tempo reale “vedere mentre si fresa”
Il Crossbeam 750 consente un imaging SEM continuo in tutte le condizioni di fresatura, dalla rimozione del materiale ad alta corrente alla lucidatura fine a basse tensioni di accelerazione fino a 0,5 kV. Questa capacità permette agli operatori di osservare direttamente le interazioni FIB–campione e di regolare i parametri in tempo reale.
Questo livello di controllo è particolarmente rilevante nella preparazione di lamelle per microscopia elettronica a trasmissione (TEM), dove sono richiesti spessore uniforme e danni minimi. Mantenendo la visibilità durante l’intero processo, il sistema supporta il successo al primo tentativo nella fabbricazione delle lamelle e riduce la necessità di correzioni iterative.
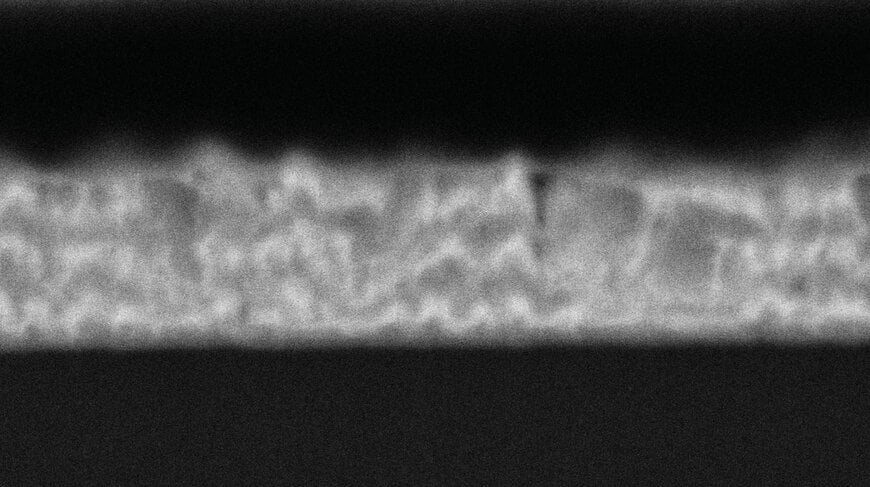
Ottica Gemini 4 per imaging ad alta risoluzione
Il sistema integra la nuova ottica elettronica Gemini 4, che offre una risoluzione migliorata e un rapporto segnale-rumore superiore. Ciò consente un imaging privo di background e prestazioni stabili a basse energie di atterraggio, fondamentali per materiali sensibili e analisi ad alta precisione.
Le prestazioni di imaging migliorate supportano applicazioni che richiedono una caratterizzazione strutturale dettagliata, inclusi dispositivi semiconduttori avanzati e sistemi di materiali su scala nanometrica.
Applicazioni nei flussi di lavoro avanzati per semiconduttori e materiali
Il Crossbeam 750 è progettato per applicazioni nei semiconduttori di nodi avanzati, inclusi dispositivi logici e di memoria basati su architetture come gate-all-around (GAA) e transistor complementari FET (CFET). Queste strutture richiedono un’accuratezza su scala nanometrica durante il sezionamento e l’assottigliamento dei campioni.
Oltre ai semiconduttori, il sistema supporta una gamma di applicazioni nelle scienze dei materiali e della vita, tra cui:
- Preparazione di lamelle TEM per microscopia ad alta risoluzione
- Preparazione di campioni per tomografia a sonda atomica (APT)
- Processi di nanofabbricazione come la litografia a fascio elettronico
- Imaging volumetrico tridimensionale (3D) e tomografia
L’ampio campo visivo privo di distorsioni migliora la qualità dei dati nella tomografia 3D, mentre condizioni di imaging stabili a basso kV aumentano il contrasto e riducono i tempi di acquisizione.

Maggiore produttività e riproducibilità
Eliminando la necessità di interrompere la fresatura per l’imaging, il Crossbeam 750 semplifica i flussi di lavoro e riduce il tempo totale di elaborazione. Il monitoraggio continuo consente risultati più coerenti, in particolare in ambienti ad alta produttività in cui la riproducibilità è fondamentale.
La capacità di raggiungere endpoint precisi al primo tentativo è particolarmente preziosa nell’analisi dei guasti nei semiconduttori e nello sviluppo dei processi, dove deviazioni su scala nanometrica possono influenzare le prestazioni dei dispositivi.
Posizionamento nei sistemi FIB-SEM
Le piattaforme FIB-SEM sono ampiamente utilizzate per la preparazione e l’analisi di campioni su scala nanometrica. Sistemi comparabili includono la serie Helios di Thermo Fisher Scientific e le piattaforme FERA di Tescan, che combinano anch’esse la fresatura con fascio ionico e l’imaging elettronico.
I principali fattori di differenziazione in questo segmento includono la risoluzione dell’imaging a basse tensioni, la visibilità del processo in tempo reale e la qualità del campo visivo per la ricostruzione 3D. L’integrazione dell’imaging SEM continuo durante la fresatura e l’ottica elettronica avanzata del Crossbeam 750 mirano a questi parametri prestazionali, in particolare per nodi semiconduttori avanzati e ricerca sui materiali ad alta precisione.
Combinando imaging e fresatura simultanei con prestazioni ottiche migliorate, il Crossbeam 750 risponde alle esigenze in evoluzione nella fabbricazione e nell’analisi su scala nanometrica, dove il controllo del processo e la fedeltà dell’imaging influenzano direttamente i risultati.
Modificato da Natania Lyngdoh, Editor Induportals — Adattato da AI.
www.zeiss.com

Maggiore produttività e riproducibilità
Eliminando la necessità di interrompere la fresatura per l’imaging, il Crossbeam 750 semplifica i flussi di lavoro e riduce il tempo totale di elaborazione. Il monitoraggio continuo consente risultati più coerenti, in particolare in ambienti ad alta produttività in cui la riproducibilità è fondamentale.
La capacità di raggiungere endpoint precisi al primo tentativo è particolarmente preziosa nell’analisi dei guasti nei semiconduttori e nello sviluppo dei processi, dove deviazioni su scala nanometrica possono influenzare le prestazioni dei dispositivi.
Posizionamento nei sistemi FIB-SEM
Le piattaforme FIB-SEM sono ampiamente utilizzate per la preparazione e l’analisi di campioni su scala nanometrica. Sistemi comparabili includono la serie Helios di Thermo Fisher Scientific e le piattaforme FERA di Tescan, che combinano anch’esse la fresatura con fascio ionico e l’imaging elettronico.
I principali fattori di differenziazione in questo segmento includono la risoluzione dell’imaging a basse tensioni, la visibilità del processo in tempo reale e la qualità del campo visivo per la ricostruzione 3D. L’integrazione dell’imaging SEM continuo durante la fresatura e l’ottica elettronica avanzata del Crossbeam 750 mirano a questi parametri prestazionali, in particolare per nodi semiconduttori avanzati e ricerca sui materiali ad alta precisione.
Combinando imaging e fresatura simultanei con prestazioni ottiche migliorate, il Crossbeam 750 risponde alle esigenze in evoluzione nella fabbricazione e nell’analisi su scala nanometrica, dove il controllo del processo e la fedeltà dell’imaging influenzano direttamente i risultati.
Modificato da Natania Lyngdoh, Editor Induportals — Adattato da AI.
www.zeiss.com
Richiedi maggiori informazioni…

